燒結銀導電膠(無壓燒結)專用於第三代半導體晶片封裝6806SC/6810SC/6818SC: 
WBC(Wafer Backside Coating)封裝8980C/8960I:
先進封裝材料


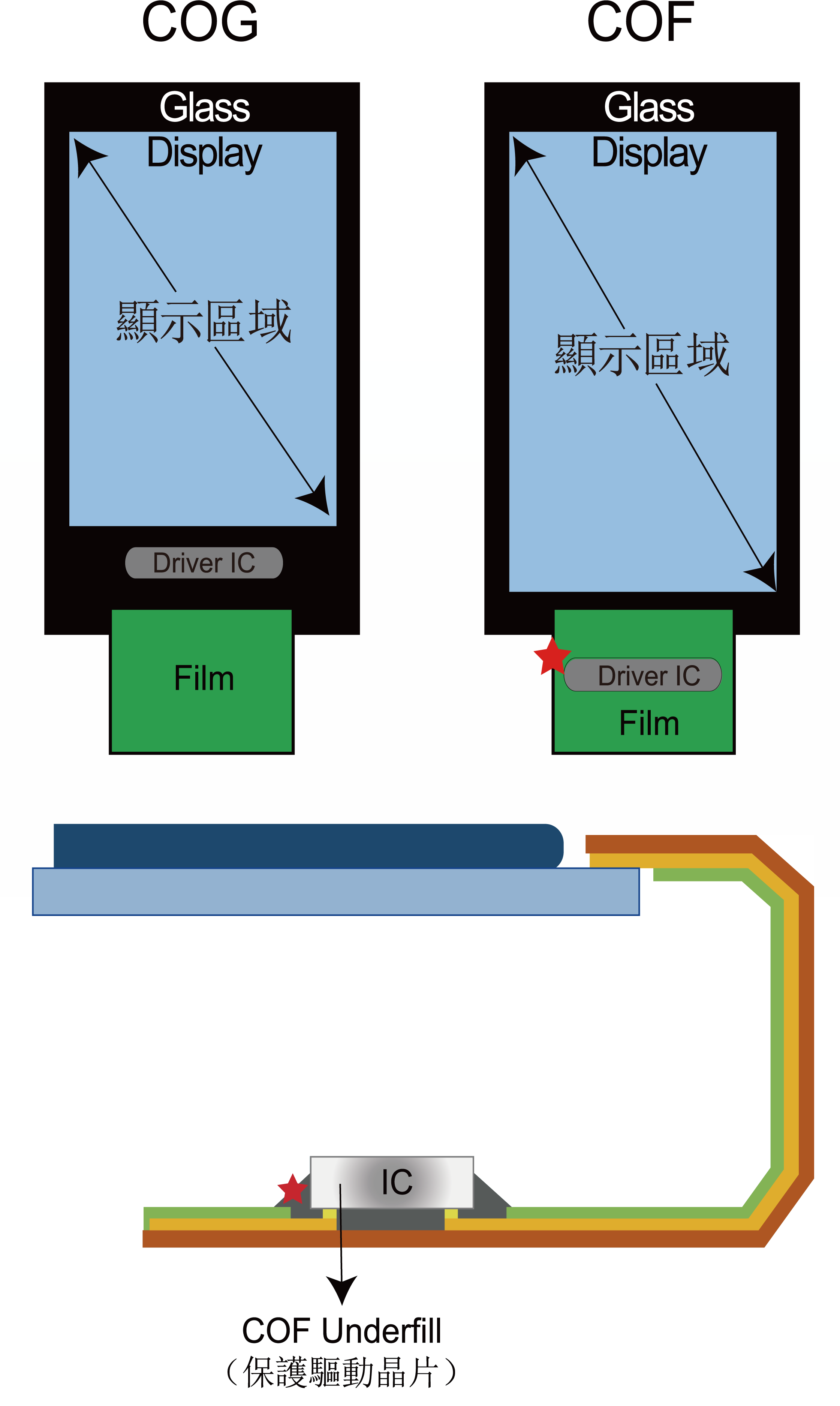
COF用底填封裝材料
激光雷射應用
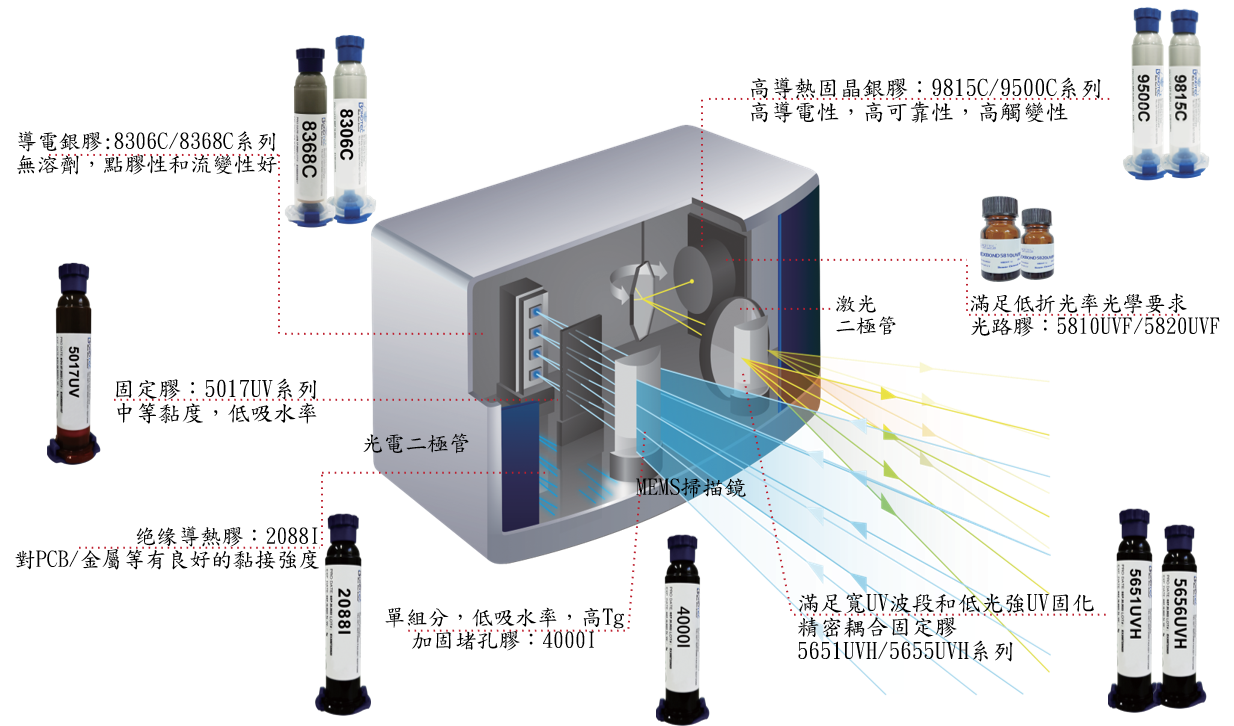
汽車領域應用


- 黏度 CP (5 rpm) : 20000~40000.
- 導熱性能 (W/m °K): 60W, 100W, 180W.
- 寬禁帶半導體(電力電子器件/激光和探測器/射頻和微波功率器件/半導體照明等)高導熱、高功率的器件封裝。
WBC(Wafer Backside Coating)封裝8980C/8960I:

- 適用於半導體晶圆背部刷膠製程, B-Stage烘烤, 具高Tg、黏接可靠性。
先進封裝材料
- Under fill-7190/7191 3/5μm粒徑的晶圓級底填膠。高Tg、高窄間距填充性和高黏接性,適用於2.5D封裝。
- Liquid Molding Compound-7515/7505 低黏度、高流性,具窄間隙及良好填充性,適用2.5/3D封裝。



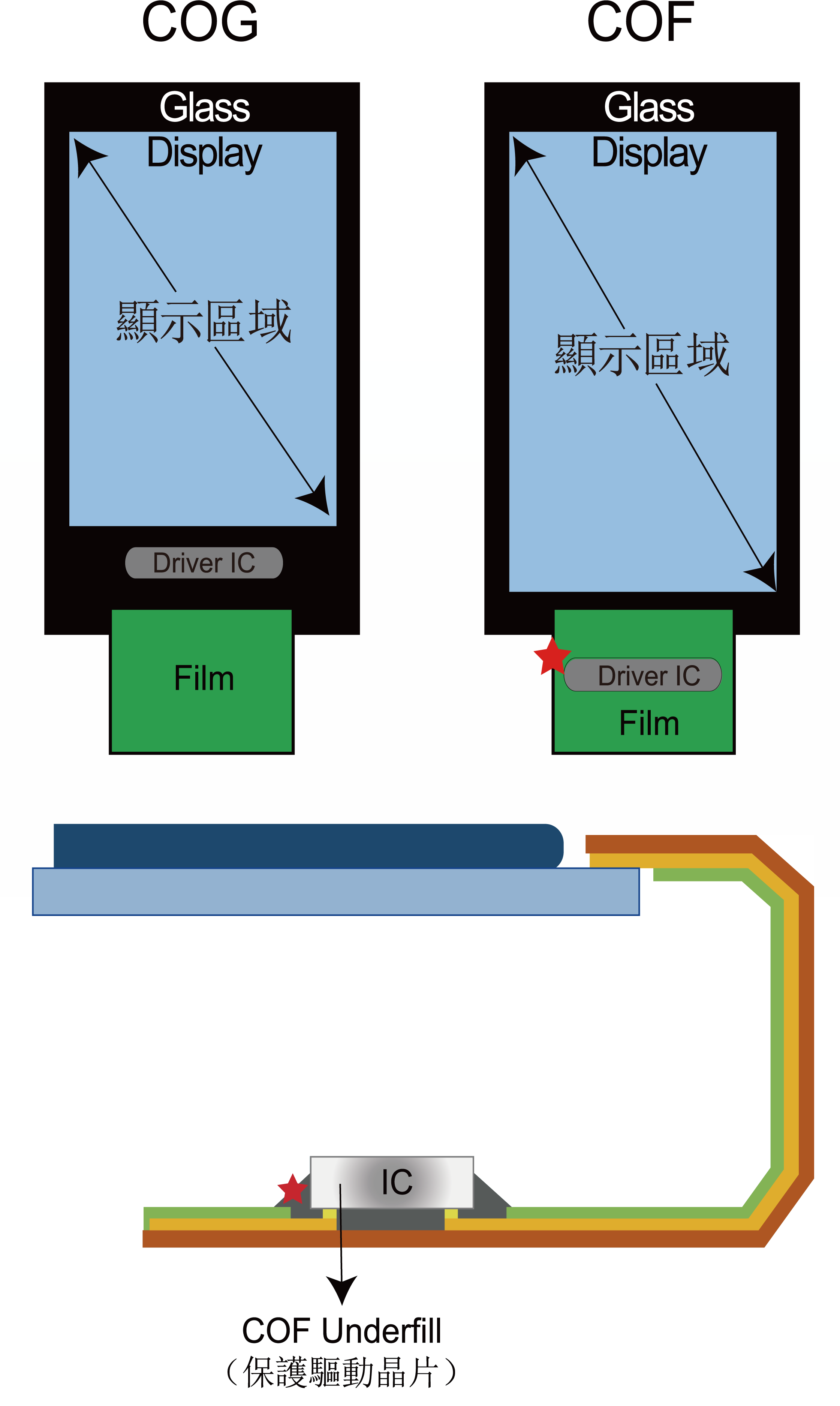
COF用底填封裝材料
- 小Bump間距(Space)和窄間隙(Pitch)兼容性高快速固化適用柔板的高可靠性底部填充膠。
激光雷射應用
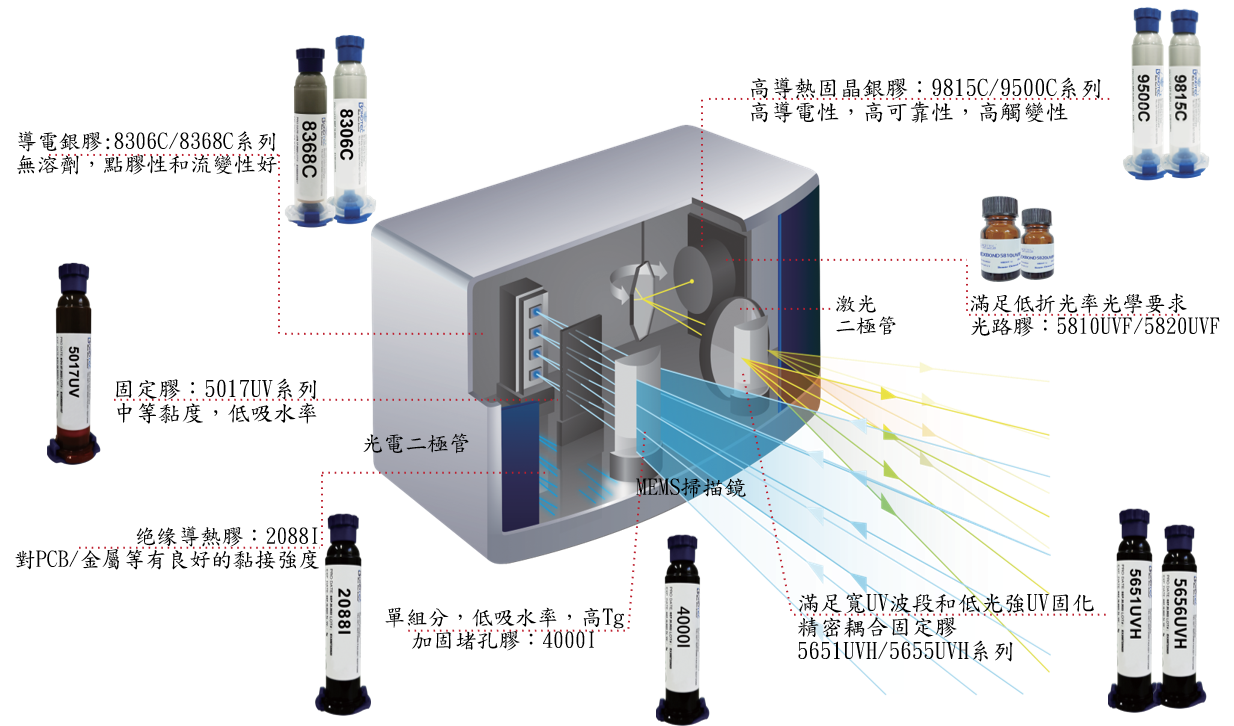
汽車領域應用



